由于电子技术的不断发展,半导体产业日新月异。由于销售市场的消费市场,各种电子设备控制部件的生产工艺也朝着体积小、特点高、能耗低的方向发展。IC封装形式的DFN,QFN,BGA加工工艺类型。
现阶段,IC切割外包装成品通常是一把整体软刀。如何保证外包装后产品的切割率?除了产品设计、设备精度、制造工艺和工作环境外,刀片的精确选择和整体可靠性是不可或缺的。以下是深圳西斯特自主设计、产品研发、生产制造的整体软刀及具体加工实例。
01整体软刀加工DFN基本原理
切割刀片组装在切割机器设备的主轴轴承软刀法兰上。在主轴轴承每分钟20000-30000转之间的高速运行下,根据叶片中的冲击,金钢石颗粒物(Fracturing)方法是什么?摆脱工件必须切割的部分,用伤口切割(Chippocket)立即去除头皮屑,确保产品质量。
02详细介绍整体型软刀
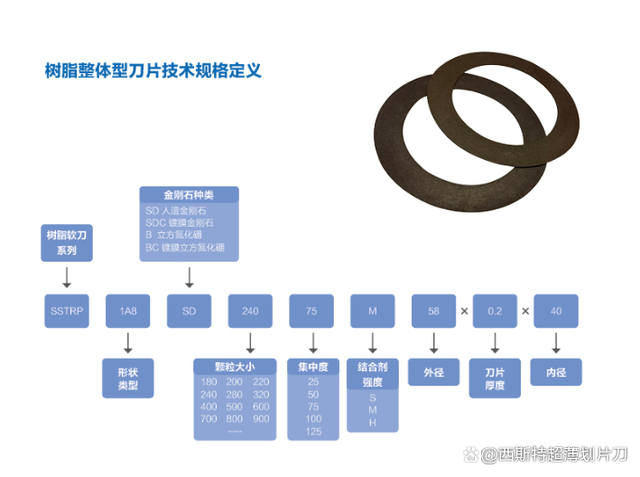
03环氧树脂整体软刀主要用途
关键加工:DFN,QFN,PCB,BGA,LGA,安全玻璃等原材料。
根据市场集中度的调整,粘合剂和金刚石颗粒也可以合理提高加工质量和叶片利用率,处理金属材料毛边、商品分层、引脚熔锡、切割加工工艺、蛇切割、断裂等常见产品质量问题。
04加工实例

05切割实际效果
40次显微镜下,检查无毛边、坍塌、金属材料分层等异常质量。
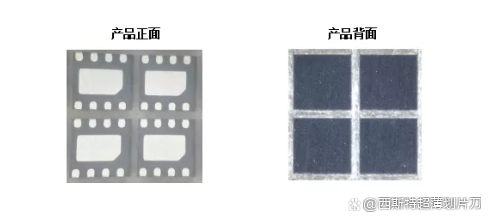
根据挑选适合自己的加工耗品,融合科学合理的加工主要参数,比较容易切割。