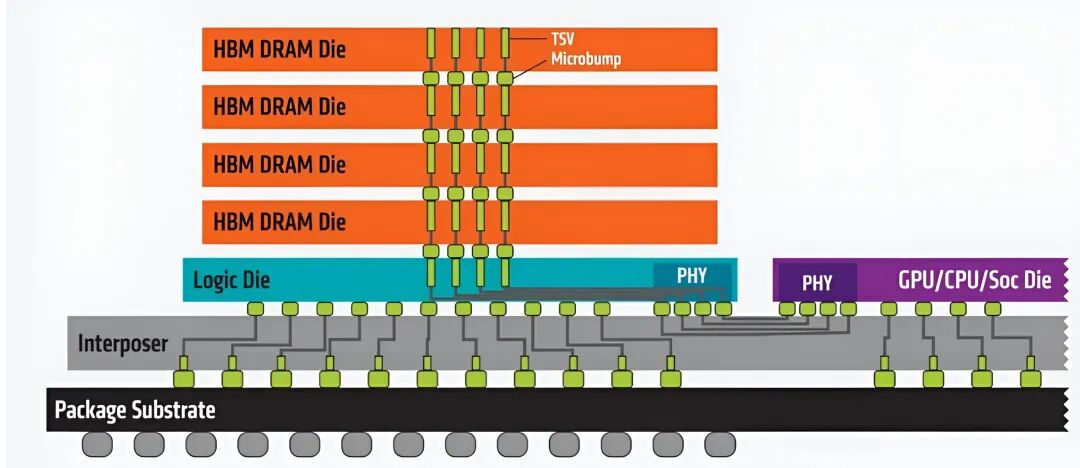 HBM概念及其技术要点HBM具备高带宽、低功耗、高集成度等优点。
HBM概念及其技术要点HBM具备高带宽、低功耗、高集成度等优点。
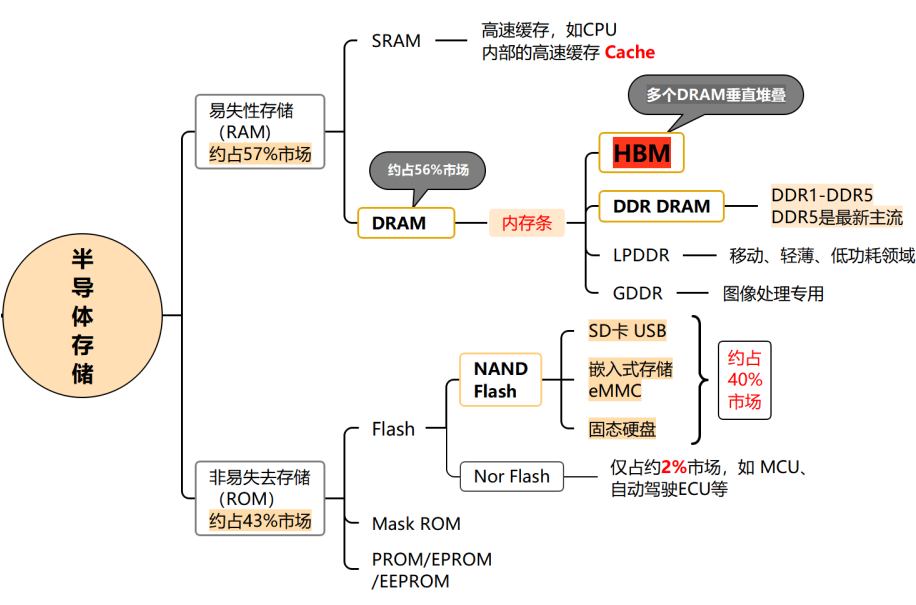 HBM存储国产率不足2%当前存储芯片市场正处于一个AI叠加的“超级周期”。
HBM存储国产率不足2%当前存储芯片市场正处于一个AI叠加的“超级周期”。
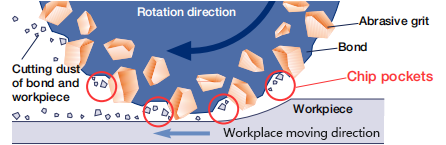 划片刀相关名词解释:排屑槽和自锐性划片刀对晶圆等硬脆材料进行切割,得靠排屑槽排出切削废料。
划片刀相关名词解释:排屑槽和自锐性划片刀对晶圆等硬脆材料进行切割,得靠排屑槽排出切削废料。
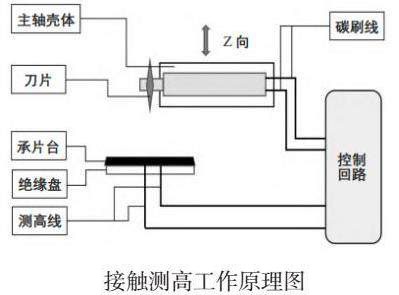 论晶圆划切过程中设备测高的重要性设备测高不是单一模式,有接触性测高、非接触性测高两大基础方式。
论晶圆划切过程中设备测高的重要性设备测高不是单一模式,有接触性测高、非接触性测高两大基础方式。
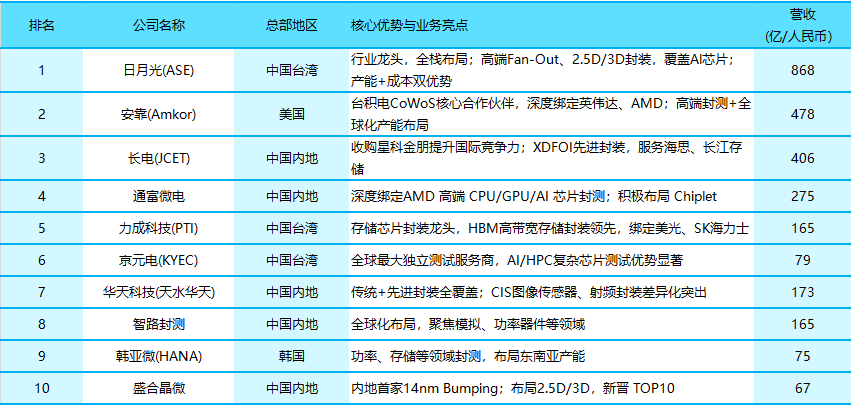 深耕晶圆级先进封测领域——盛合晶微科创板IPO马年上会盛合晶微于2月24日迎来科创板IPO上市委现场审议
深耕晶圆级先进封测领域——盛合晶微科创板IPO马年上会盛合晶微于2月24日迎来科创板IPO上市委现场审议
 高潜力的氮化镓晶圆安森美与格罗方德为高增长市场打造全新650V功率器件
高潜力的氮化镓晶圆安森美与格罗方德为高增长市场打造全新650V功率器件
 车规级MCU全了解MCU主要由中央处理器CPU、存储器(ROM和RAM)、输入输出I/O接口、串行口、计数器等构成。
车规级MCU全了解MCU主要由中央处理器CPU、存储器(ROM和RAM)、输入输出I/O接口、串行口、计数器等构成。
 晶圆划片刀行业近年主要政策政策导向正从普惠性鼓励转向精准化扶持,覆盖研发、市场到下游应用全链条。
晶圆划片刀行业近年主要政策政策导向正从普惠性鼓励转向精准化扶持,覆盖研发、市场到下游应用全链条。
 封装工程有五个层级,划片刀应用在哪个层级?封装层次的划分并不是绝对的,随着先进封装技术的发展,层次边界正在逐渐模糊
封装工程有五个层级,划片刀应用在哪个层级?封装层次的划分并不是绝对的,随着先进封装技术的发展,层次边界正在逐渐模糊
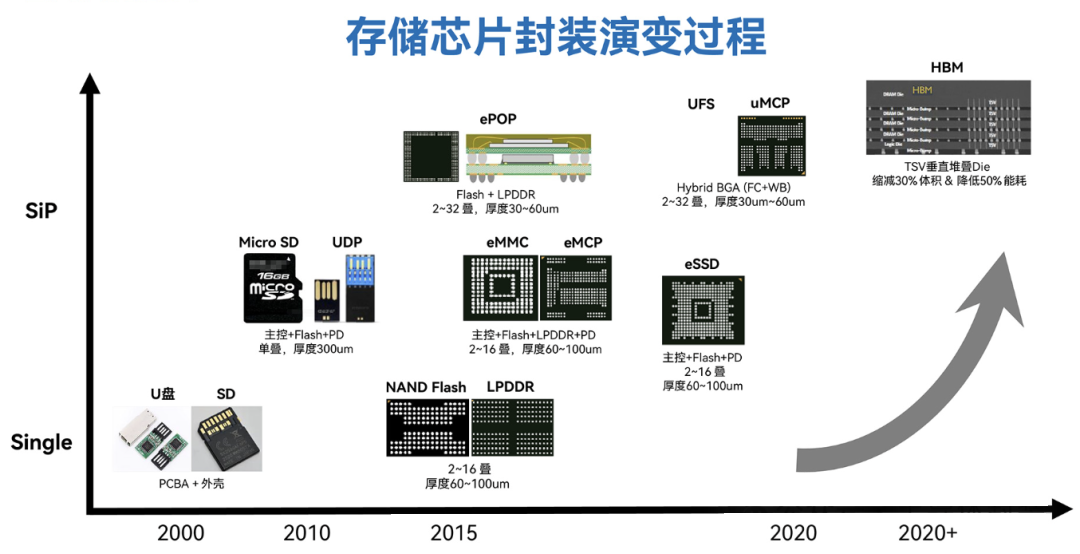 存储芯片“严重短缺”,涨价大幕已拉开封测厂商势必将在2026年,继续扮演AI供应链中不可或缺的关键角色。
存储芯片“严重短缺”,涨价大幕已拉开封测厂商势必将在2026年,继续扮演AI供应链中不可或缺的关键角色。