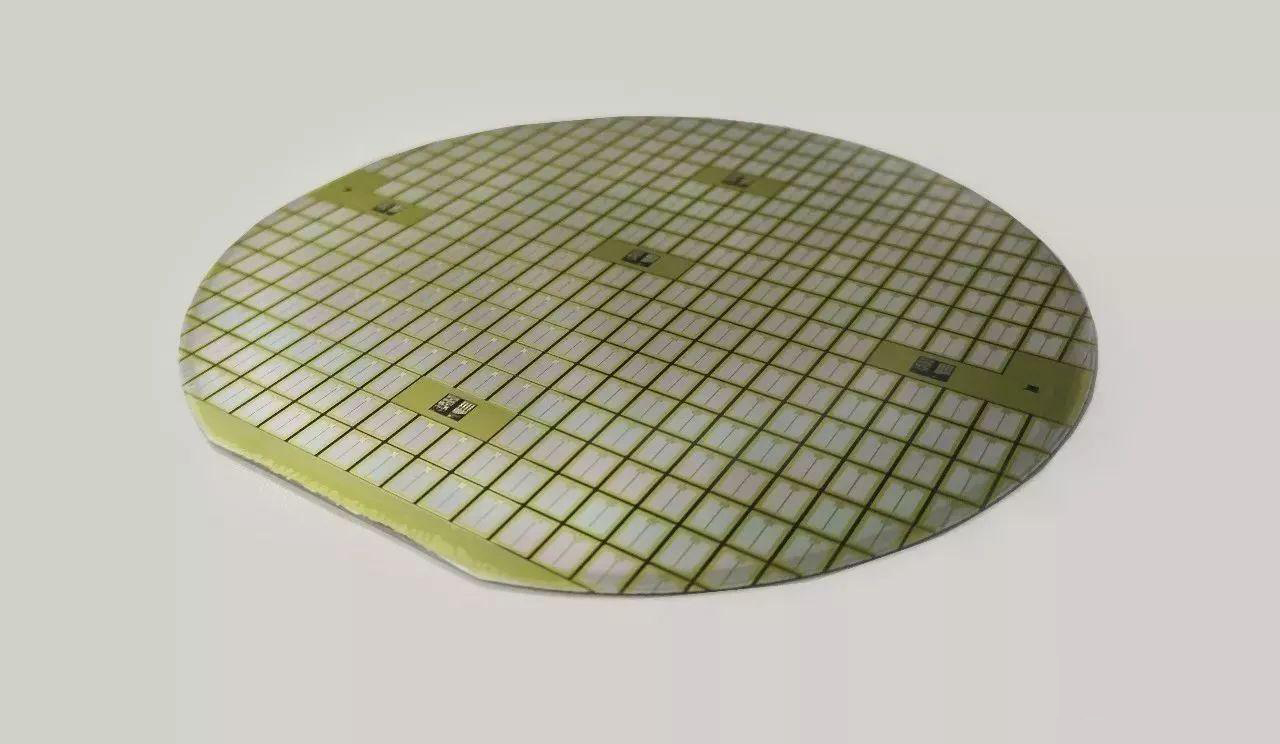 Macom专注提升GaN-on-SiC产能Macom通过收购Wolfspeed射频业务,拓展其在国防、航空航天等领域的应用场景。
Macom专注提升GaN-on-SiC产能Macom通过收购Wolfspeed射频业务,拓展其在国防、航空航天等领域的应用场景。
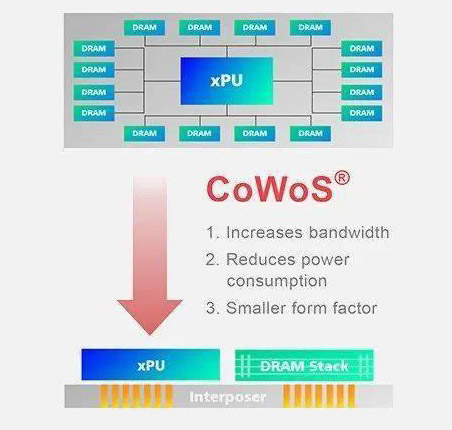 美国放开H20芯片出口中国限制CoWoS严格来说属于2.5D先进封装技术
美国放开H20芯片出口中国限制CoWoS严格来说属于2.5D先进封装技术
 碳化硅衬底尺寸格局根据电学性能差异区分,碳化硅衬底分为导电型衬底和半绝缘型衬底。
碳化硅衬底尺寸格局根据电学性能差异区分,碳化硅衬底分为导电型衬底和半绝缘型衬底。
 小米YU7大卖,带动国产碳化硅供应链升级随着小米旗下车型的大批量交付,将助力国产碳化硅供应链进一步完善升级。
小米YU7大卖,带动国产碳化硅供应链升级随着小米旗下车型的大批量交付,将助力国产碳化硅供应链进一步完善升级。
 碳化硅将迎来快速增长SiC衬底是第三代半导体材料中氮化镓、SiC应用的基石。
碳化硅将迎来快速增长SiC衬底是第三代半导体材料中氮化镓、SiC应用的基石。
 存储芯片带动半导体行业复苏除人工智能(AI)之外的通用存储器需求持续低迷,中国后来者正在积极扩大产量,存储市场的未来正在引发担忧。
存储芯片带动半导体行业复苏除人工智能(AI)之外的通用存储器需求持续低迷,中国后来者正在积极扩大产量,存储市场的未来正在引发担忧。
 陶瓷基板切割要注意材料分类陶瓷基板切割要注意材料区分,且表面金属会影响切割品质。
陶瓷基板切割要注意材料分类陶瓷基板切割要注意材料区分,且表面金属会影响切割品质。
 先进封装技术往玻璃基封装开进玻璃基板在AI芯片大尺寸封装当中可以克服有机基板的翘曲问题
先进封装技术往玻璃基封装开进玻璃基板在AI芯片大尺寸封装当中可以克服有机基板的翘曲问题
 准确切割的典范——探讨DFN切割切割工艺在现代制造业中,准确度和效率是衡量工艺技术的关键指标。而DFN切割工艺便是在这样的标准下应运而生的一种高精度切割技术。它以精细的切割效果、快速的工作效率以及广泛的应用范围,成为众多领域中...
准确切割的典范——探讨DFN切割切割工艺在现代制造业中,准确度和效率是衡量工艺技术的关键指标。而DFN切割工艺便是在这样的标准下应运而生的一种高精度切割技术。它以精细的切割效果、快速的工作效率以及广泛的应用范围,成为众多领域中...
 晶圆划片刀的多样形状解析在半导体制造过程中,晶圆划片刀扮演着至关重要的角色。正如裁缝的剪刀对布料进行准确剪裁,晶圆划片刀也需对硅晶圆进行精细分割,确保集成电路芯片的质量与性能。这些刀具的形状设计,犹如雕刻家选择...
晶圆划片刀的多样形状解析在半导体制造过程中,晶圆划片刀扮演着至关重要的角色。正如裁缝的剪刀对布料进行准确剪裁,晶圆划片刀也需对硅晶圆进行精细分割,确保集成电路芯片的质量与性能。这些刀具的形状设计,犹如雕刻家选择...