PoP:Package-on-Package Assembly/堆叠封装
实现 3D 集成的较简单方案之一,是将已完成封装的芯片进行堆叠。这类方案的技术名称中通常包含 “PoP”(即 “封装堆叠”)。该技术的一个典型应用场景是将 DRAM 芯片堆叠在逻辑芯片上方,台积电(TSMC)的 InFO 封装技术中,就包含此类堆叠方案。
PoP方案的流程为:先将芯片倒扣在载体晶圆上,再进行塑封;移除载体晶圆后,制作重布线层与焊球;最后对重构晶圆进行切割,完成封装。
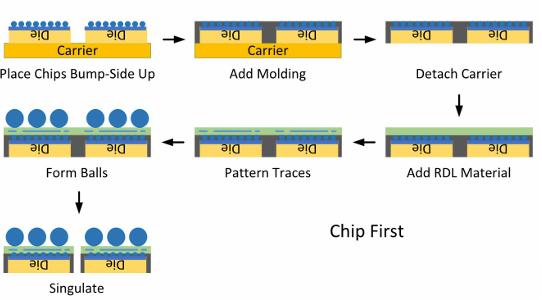
CoW:Chip on Wafer Assembly/晶圆级芯片集成
在封装中实现芯片互连的早期方案之一,是采用晶圆作为载体,并在其上制作重布线层(RDL),台积电将该技术品牌化为 “CoW”(晶圆级芯片集成)。
CoW方案的流程为:先在载体晶圆上制作重布线层(RDL),再将预先切割好的芯片(焊凸朝下)放置在载体上;随后对芯片进行塑封,形成 “重构晶圆”(reconstituted wafer);之后移除载体晶圆,制作焊球,最后对重构晶圆进行切割( singulate),得到独立封装体。
英特尔(Intel)的 Foveros 工艺是PoP技术的另一变体,主要用于实现两颗芯片(或一颗芯片与一个有源中介层)的面对面键合。其中,下方芯片需朝上放置,并通过硅通孔(TSV)与基板实现连接。
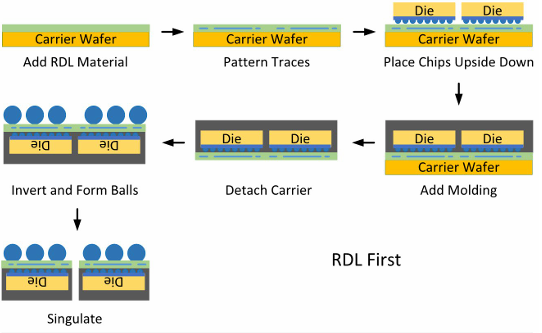
CoWoS:在CoW方案基础上加入中介层
前文介绍的方案仅通过重布线层(RDL)实现信号向焊球的布线。若在封装中加入中介层,则能进一步提升布线灵活性。台积电的 CoWoS(晶圆级系统集成封装)是最知名的案例之一,该技术根据中介层的类型分为三个变体:
①CoWoS-S:采用硅中介层
②CoWoS-R:采用有机材料制作重布线层(无独立中介层,以有机 RDL 替代中介层功能)
③CoWoS-L:采用小型芯片作为 “布线载体”—— 其结构类似硅桥(silicon bridge),但额外具备通向基板的通孔(vias),可直接与基板连接。