技术区别
TSV硅通孔(Through Silicon Via),指连接硅晶圆两面并与硅衬底和其他通孔绝缘的电互连结构。
硅中介层有TSV的集成是最常见的一种2.5D集成技术,芯片通常通过MicroBump和中介层相连接,作为中介层的硅基板采用Bump和基板相连,硅基板表面通过RDL布线,TSV作为硅基板上下表面电气连接的通道。
这种2.5D集成适合芯片规模比较大,引脚密度高的情况,芯片一般以FlipChip形式安装在硅基板上。
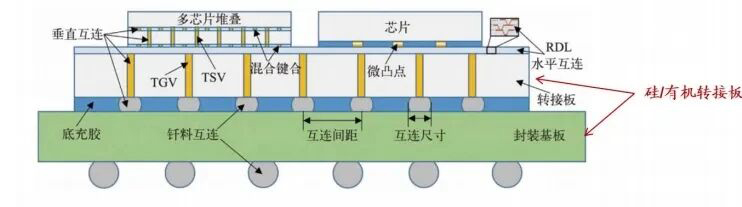
TSV技术
TGV玻璃通孔(Through Glass Via),是通过在玻璃基板上制作垂直贯通的微小通孔,并在通孔中填充导电材料(CU),从而实现不同层面间的电气连接。
TGV以高品质硼硅玻璃、石英玻璃为基材,通过种子层溅射、电镀填充、化学机械平坦化、RDL再布线, bump工艺引出实现3D互联,被视为下一代先进封装集成的关键技术。
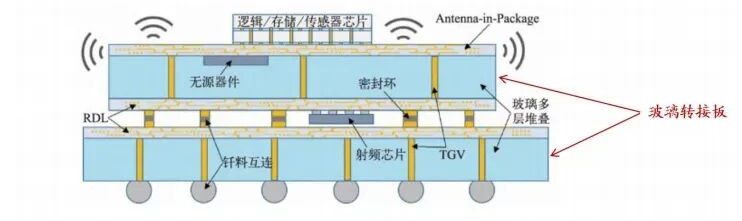
TGV技术
形象比喻
TSV是在“实心混凝土”(硅)里凿电梯井,而TGV则是在“透明玻璃”里铺设地铁隧道。玻璃本身是高度绝缘的,所以这条“隧道”天生就拥有更干净、更高速的通行环境。

切割难点
不论是TSV还是TGV,都需要再晶圆级封装后分离出独立封装单元,满足后续组装需求。
TSV 器件通常由硅基板、金属填充层(铜为主)、介电绝缘层(如 SiO₂)、堆叠键合层(如聚合物胶)组成,不同材料的物理特性差异导致切割过程易产生缺陷。
TGV 常用于高频芯片、MEMS 传感器的小型化封装,常用厚度小于100μm 的超薄玻璃基板,基于整片玻璃晶圆的切割分离,因为其脆性、硬度及热稳定性直接导致切单难度显著高于TSV。以2.5D 封装的TGV转接板为例,切割线与边缘通孔的距离通常需控制在 10μm 以内,对切割设备的定位精度和切割刀具的切割精度都有极高要求。
具体切割方案欢迎咨询西斯特划片刀应用团队