HBM,全称High Bandwidth Memory,即高带宽内存,是一种基于3D堆叠工艺的高性能半导体存储器。具备高带宽、低功耗、高集成度等优点,专为解决AI时代高性能计算场景下的内存带宽瓶颈而生。
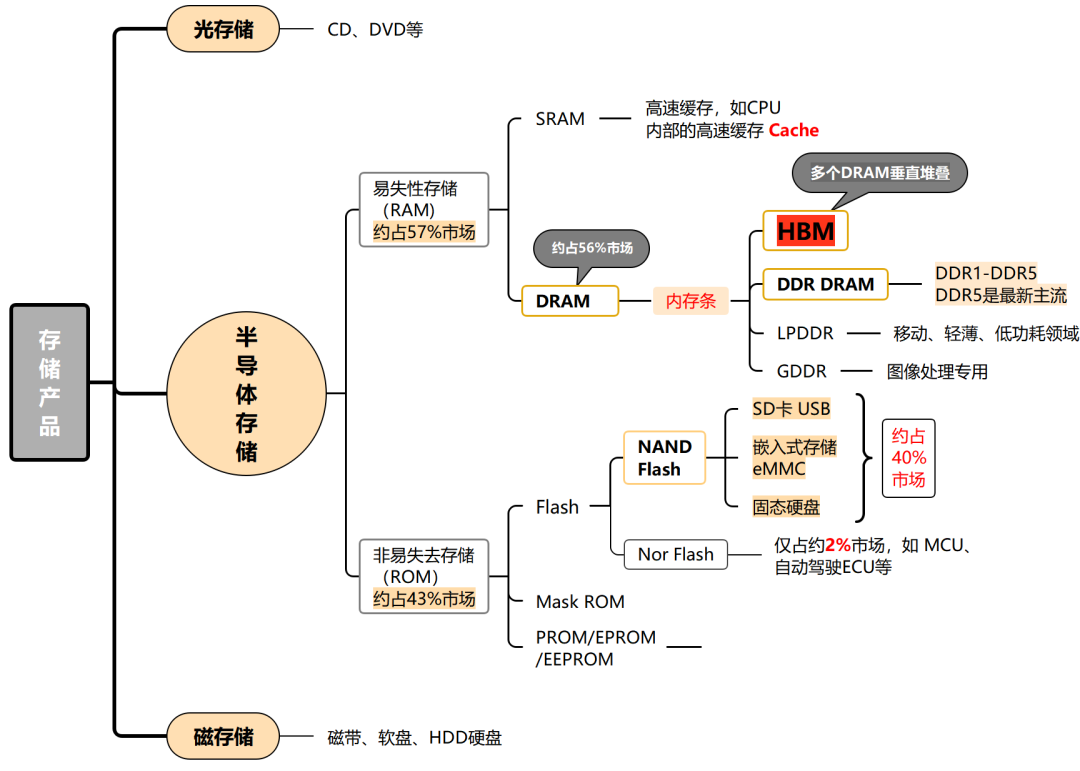
其本质上是基于2.5/3D堆叠封装技术,把多块DRAM垂直堆叠起来后与GPU芯片封装在一起,实现大容量、高位宽的DDR组合阵列。在结构上,HBM是由多个DRAM 堆叠而成,主要利用TSV(硅通孔)和微凸块(Micro bump)将裸片相连接,多层 DRAM die 再与最下层的 Base die 连接,然后通过凸块(Bump)与硅中阶层(interposer)互联。
同一平面内,HBM与GPU、CPU或 ASIC 共同铺设在硅中阶层上,再通过 CoWoS 等 2.5D 先进封装工艺相互连接,硅中介层通过CuBump 连接至封装基板上,最后封装基板再通过锡球与下方 PCB 基板相连。
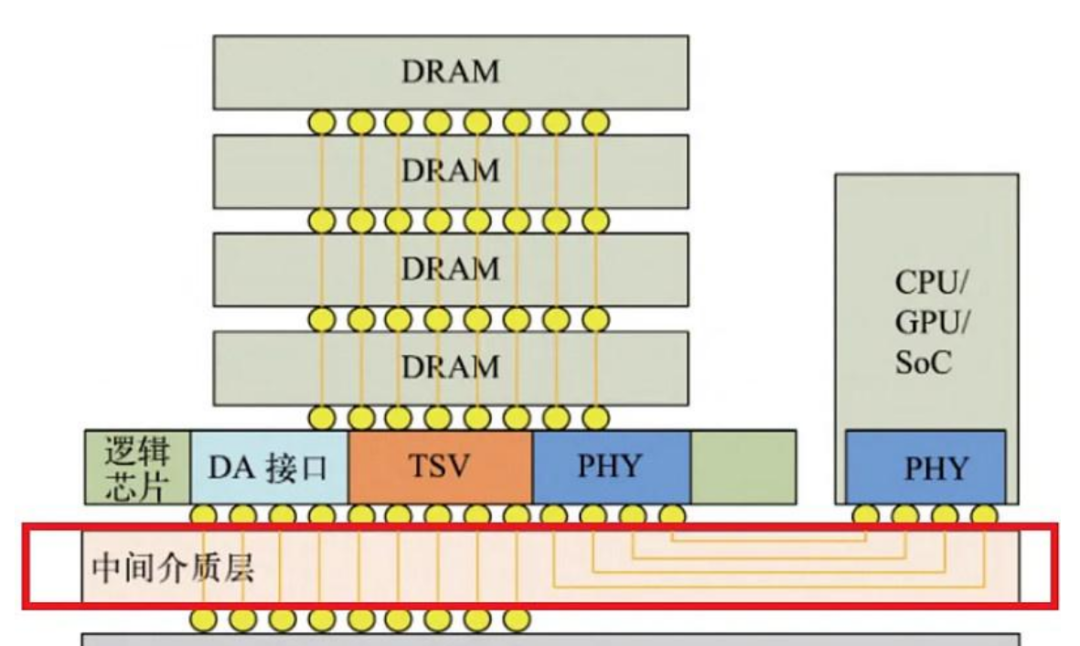
HBM生产的核心难点在于晶圆级先进封装技术,主要包括TSV、micro bumping(微凸点制作) 和堆叠键合这三座大山。