 背银晶圆划切实例在晶圆背面金属化过程中,一般选择钛、镍、银作为三层背面金属。
背银晶圆划切实例在晶圆背面金属化过程中,一般选择钛、镍、银作为三层背面金属。
 选刀还需关注加工条件在晶圆划切过程中,不仅需要选择合适的划片刀,而且要关注加工条件的优化。
选刀还需关注加工条件在晶圆划切过程中,不仅需要选择合适的划片刀,而且要关注加工条件的优化。
 划片刀怎么选?手把手教你本文主要分析金刚石颗粒大小、颗粒集中度、结合剂强度、刀片厚度、刀片长度、修刀工艺几个因素的影响作用,帮助大家合理选刀。
划片刀怎么选?手把手教你本文主要分析金刚石颗粒大小、颗粒集中度、结合剂强度、刀片厚度、刀片长度、修刀工艺几个因素的影响作用,帮助大家合理选刀。
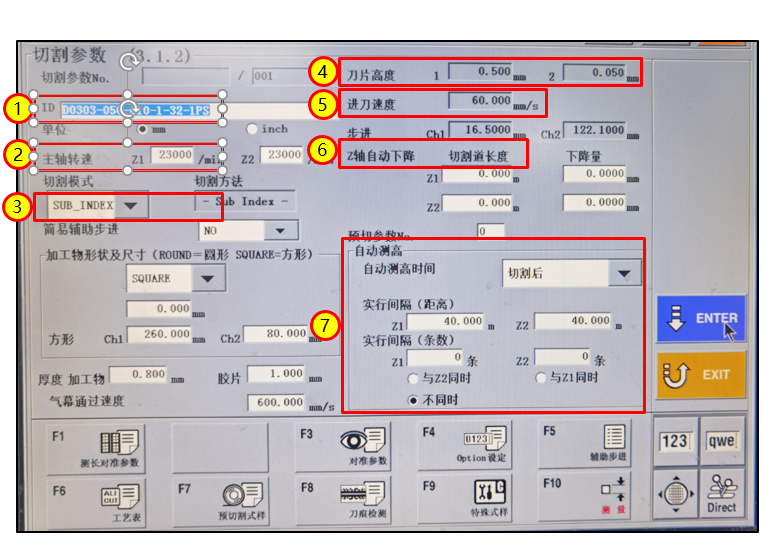 金刚石划片刀上机工艺操作详解本文将对照划片机参数界面,对划片工艺每个设置进行说明,帮助行业新手快速了解划切工艺操作流程。
金刚石划片刀上机工艺操作详解本文将对照划片机参数界面,对划片工艺每个设置进行说明,帮助行业新手快速了解划切工艺操作流程。
 人造金刚石磨料的划切机理切割刀片是由人造金刚石颗粒和结合剂组成,在划片设备空气主轴高速旋转下,针对某些材料进行切断、开槽等加工。
人造金刚石磨料的划切机理切割刀片是由人造金刚石颗粒和结合剂组成,在划片设备空气主轴高速旋转下,针对某些材料进行切断、开槽等加工。
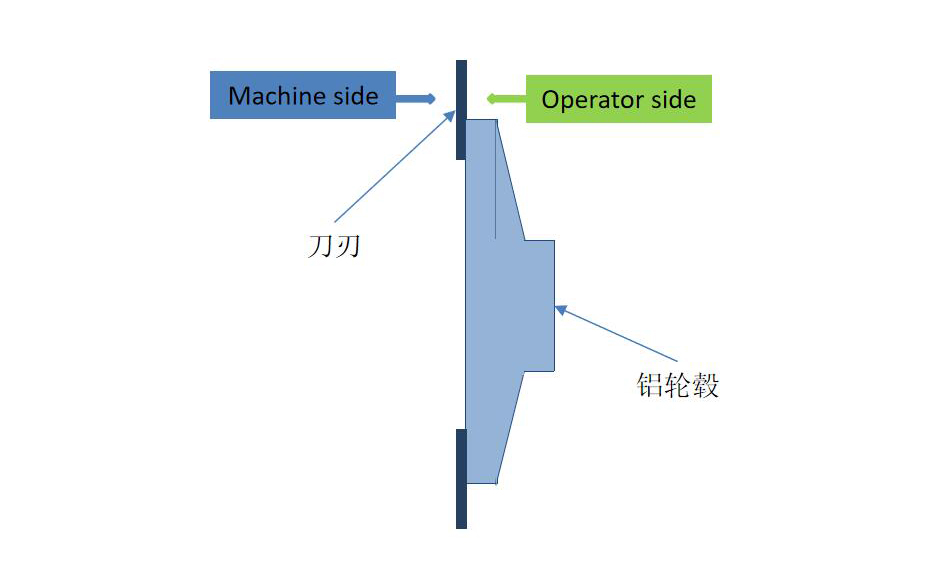 超纯水和CO2起泡器对硬刀的影响不容忽视加工硅时产生的污染物粘附在刀片上,使刀片被SiO2薄膜覆盖,从而有效避免刀片和轮毂被腐蚀。
超纯水和CO2起泡器对硬刀的影响不容忽视加工硅时产生的污染物粘附在刀片上,使刀片被SiO2薄膜覆盖,从而有效避免刀片和轮毂被腐蚀。
 合理应用修刀板提升切割品质前言在半导体相关产品切割领域里,追求更高的效率与更好的切割品质一直是各大工厂着重管控的。相信行业人员都了解,切割刀片合理应用离不开四项基本条件:设备、工件、刀片、参数,但如果这四项条件都...
合理应用修刀板提升切割品质前言在半导体相关产品切割领域里,追求更高的效率与更好的切割品质一直是各大工厂着重管控的。相信行业人员都了解,切割刀片合理应用离不开四项基本条件:设备、工件、刀片、参数,但如果这四项条件都...
 晶圆划片机主轴转速对刀片寿命及切割品质的影响在晶圆划切过程中,不仅需要选择适合的划片刀,而且要关注加工条件的优化。
晶圆划片机主轴转速对刀片寿命及切割品质的影响在晶圆划切过程中,不仅需要选择适合的划片刀,而且要关注加工条件的优化。
 晶圆研磨过程中发生破损问题的分析与解决方法在晶圆研磨过程中,会有许多造成晶圆破碎的因素存在,如何减小破损产生的机率,需要从现象出发去寻找原因。
晶圆研磨过程中发生破损问题的分析与解决方法在晶圆研磨过程中,会有许多造成晶圆破碎的因素存在,如何减小破损产生的机率,需要从现象出发去寻找原因。
 芯片封装类型汇总目前市面上的封装产品,只要芯片管脚不外露,均可使用划片刀进行切割。根据不同切割质量要求,可分为电镀软刀、金属软刀和树脂软刀。
芯片封装类型汇总目前市面上的封装产品,只要芯片管脚不外露,均可使用划片刀进行切割。根据不同切割质量要求,可分为电镀软刀、金属软刀和树脂软刀。