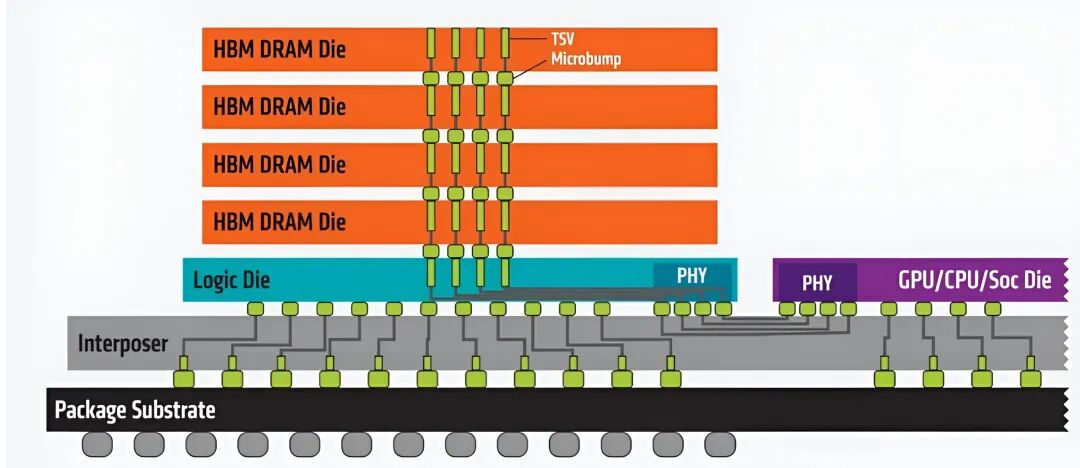 HBM概念及其技术要点HBM具备高带宽、低功耗、高集成度等优点。
HBM概念及其技术要点HBM具备高带宽、低功耗、高集成度等优点。
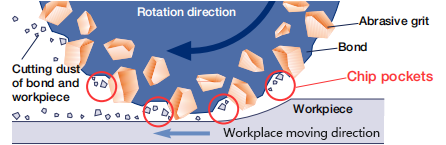 划片刀相关名词解释:排屑槽和自锐性划片刀对晶圆等硬脆材料进行切割,得靠排屑槽排出切削废料。
划片刀相关名词解释:排屑槽和自锐性划片刀对晶圆等硬脆材料进行切割,得靠排屑槽排出切削废料。
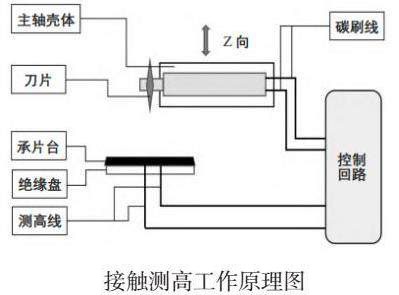 论晶圆划切过程中设备测高的重要性设备测高不是单一模式,有接触性测高、非接触性测高两大基础方式。
论晶圆划切过程中设备测高的重要性设备测高不是单一模式,有接触性测高、非接触性测高两大基础方式。
 车规级MCU全了解MCU主要由中央处理器CPU、存储器(ROM和RAM)、输入输出I/O接口、串行口、计数器等构成。
车规级MCU全了解MCU主要由中央处理器CPU、存储器(ROM和RAM)、输入输出I/O接口、串行口、计数器等构成。
 封装工程有五个层级,划片刀应用在哪个层级?封装层次的划分并不是绝对的,随着先进封装技术的发展,层次边界正在逐渐模糊
封装工程有五个层级,划片刀应用在哪个层级?封装层次的划分并不是绝对的,随着先进封装技术的发展,层次边界正在逐渐模糊
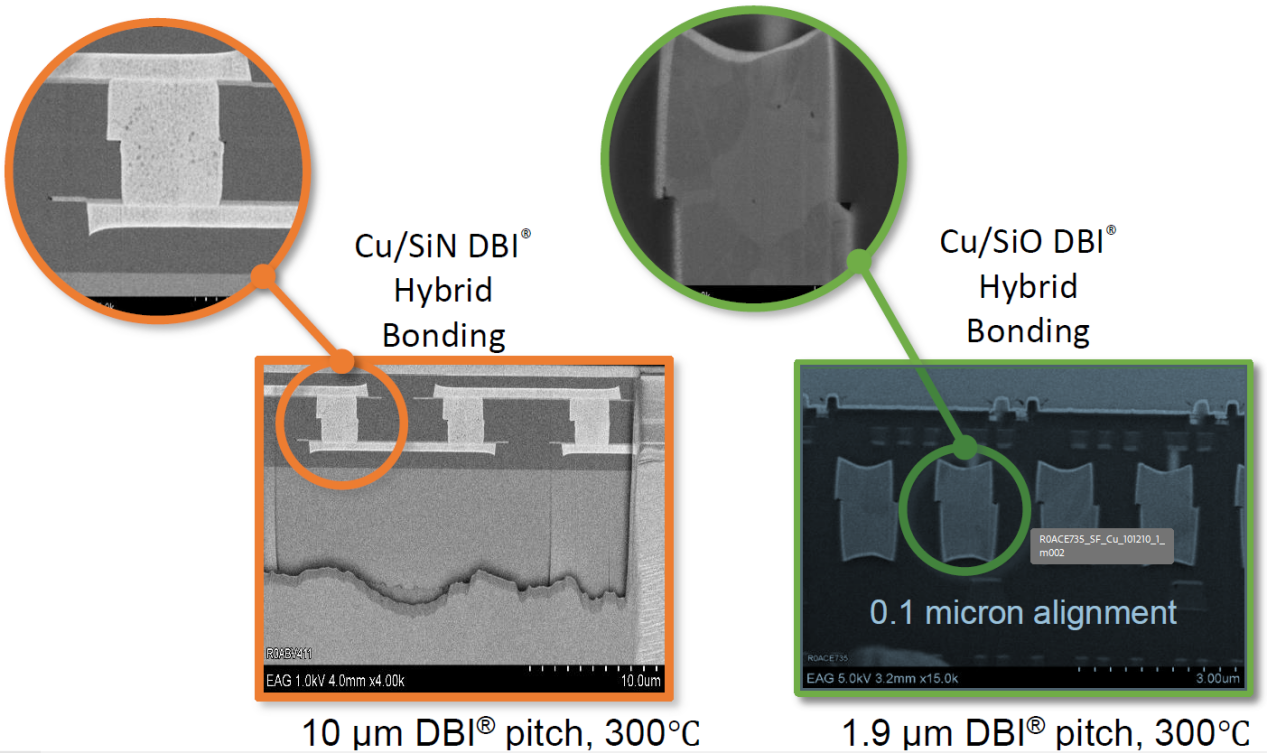 先进封装中异构集成的下一代互连互连技术的关键进步包括硅通孔 (TSV)、中介层和混合键合方法的发展。
先进封装中异构集成的下一代互连互连技术的关键进步包括硅通孔 (TSV)、中介层和混合键合方法的发展。
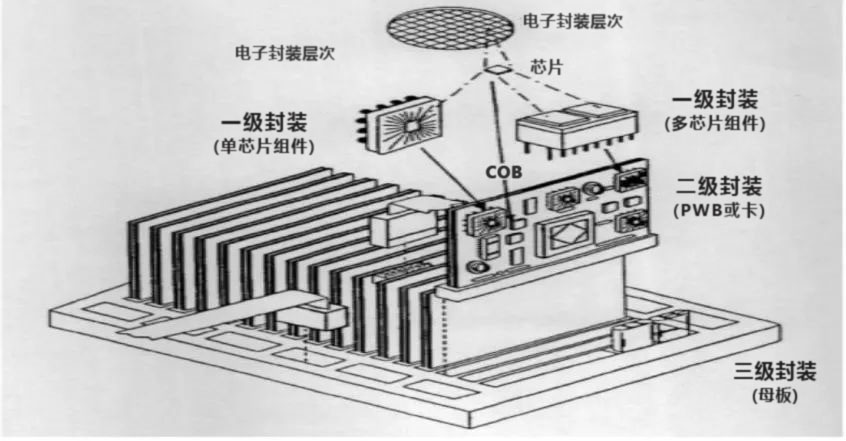 微电子封装的六个阶段和三个层次从电子封装工程的角度,按习惯一般称层次1为零级封装;层次2为一级封装;层次3为二级封装;层次4、5、6为三级封装。
微电子封装的六个阶段和三个层次从电子封装工程的角度,按习惯一般称层次1为零级封装;层次2为一级封装;层次3为二级封装;层次4、5、6为三级封装。
 TSV和TGV产品在切割上的不同难点不论是TSV还是TGV,都需要再晶圆级封装后分离出独立封装单元,满足后续组装需求。
TSV和TGV产品在切割上的不同难点不论是TSV还是TGV,都需要再晶圆级封装后分离出独立封装单元,满足后续组装需求。
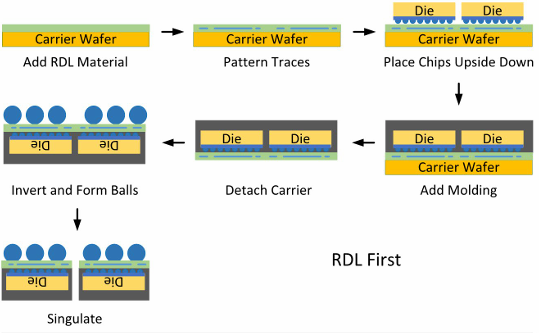 先进封装集成技术中的PoP和CoW晶圆级芯片集成
先进封装集成技术中的PoP和CoW晶圆级芯片集成
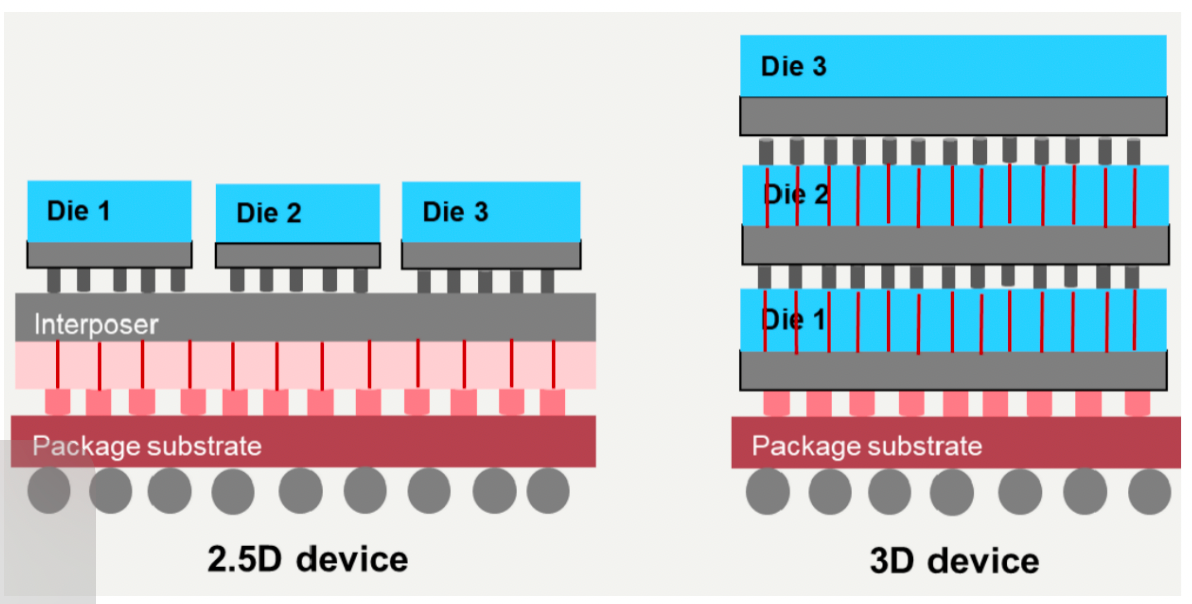 先进封装的几种形式一般来说,具备Bump、RDL、Wafer 和 TSV 四项基础要素中任意一种即可称为先进封装。
先进封装的几种形式一般来说,具备Bump、RDL、Wafer 和 TSV 四项基础要素中任意一种即可称为先进封装。