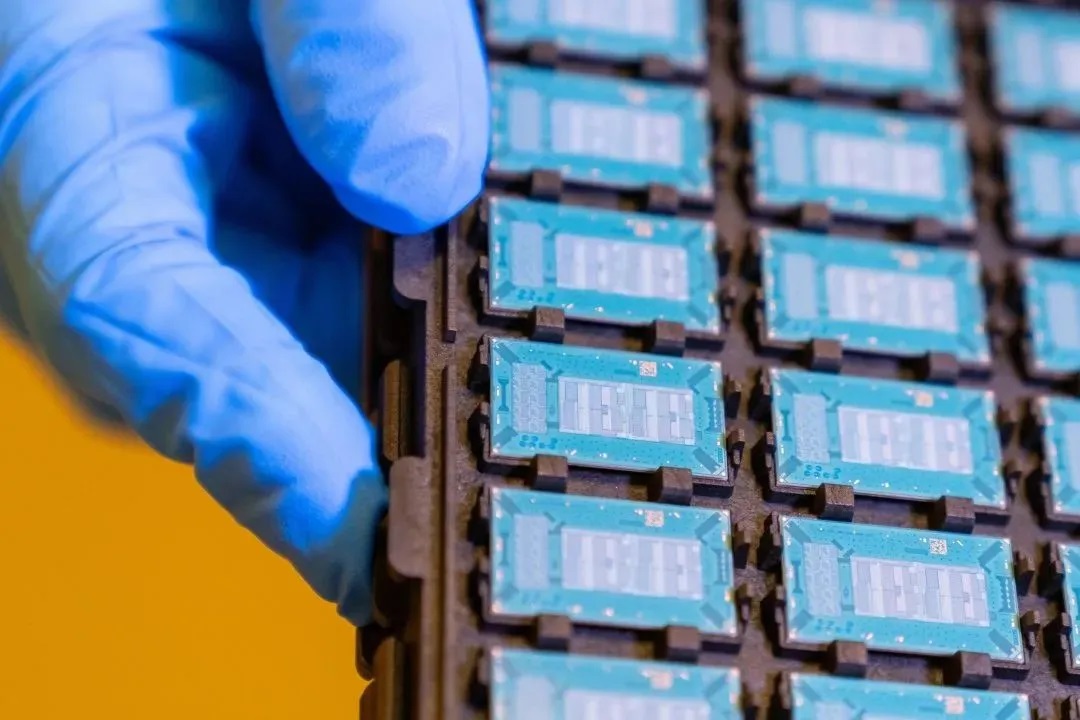 玻璃基板怎么切割?由Intel主导的玻璃基板,成为适用于下一代先进封装的材料。
玻璃基板怎么切割?由Intel主导的玻璃基板,成为适用于下一代先进封装的材料。
 芯片制造的一个重要工序-晶圆切割从沙子到成品,一个芯片要经历三次被切割。
芯片制造的一个重要工序-晶圆切割从沙子到成品,一个芯片要经历三次被切割。
 碳化硅晶圆(SiC)划切方法金刚石划片刀是目前切割SiC晶圆的常用技术
碳化硅晶圆(SiC)划切方法金刚石划片刀是目前切割SiC晶圆的常用技术
 划片机刀片之晶圆划片刀划片机刀片一般分为软刀和硬刀两种
划片机刀片之晶圆划片刀划片机刀片一般分为软刀和硬刀两种
 划片刀中的结合剂是什么磨划工具中,常见的结合剂有树脂结合剂、金属结合剂两种。
划片刀中的结合剂是什么磨划工具中,常见的结合剂有树脂结合剂、金属结合剂两种。
 划片机刀片中,软刀、硬刀有什么区别?看完就明白行业内将划片机刀片一般分为软刀和硬刀两种。有时候也被称作砂轮片。
划片机刀片中,软刀、硬刀有什么区别?看完就明白行业内将划片机刀片一般分为软刀和硬刀两种。有时候也被称作砂轮片。
 碳化硅晶圆划切方案集合碳化硅硬度高,耐磨性好,碳化硅晶片硬度大,莫氏硬度分布在...
碳化硅晶圆划切方案集合碳化硅硬度高,耐磨性好,碳化硅晶片硬度大,莫氏硬度分布在...
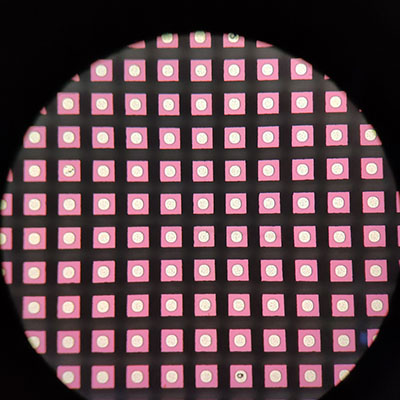 砷化镓(GaAs)晶圆切割实例切砷化镓晶圆,通常采用轮毂型电镀划片刀,选刀不当极易造成晶片碎裂,导致成品率偏低。
砷化镓(GaAs)晶圆切割实例切砷化镓晶圆,通常采用轮毂型电镀划片刀,选刀不当极易造成晶片碎裂,导致成品率偏低。
 窄迹晶圆切割实例虽然目前有其它切割方式,理论上可以实现窄迹晶圆的切割,考虑到技术成熟度不高、适用产品范围小、设备价格高等方面因素,应用金刚石划片刀仍是最优的选择。
窄迹晶圆切割实例虽然目前有其它切割方式,理论上可以实现窄迹晶圆的切割,考虑到技术成熟度不高、适用产品范围小、设备价格高等方面因素,应用金刚石划片刀仍是最优的选择。
 如何选择划片刀,看完这篇文章不求人!随着终端电子产品的多功能化,芯片的尺寸越来越小,给晶圆切割留下了不断压缩的空间。我们不仅要保证足够的成品率,还要保证加工效率,这对晶圆切割刀片和切割工艺是一个很大的挑战。从切割刀本身的制...
如何选择划片刀,看完这篇文章不求人!随着终端电子产品的多功能化,芯片的尺寸越来越小,给晶圆切割留下了不断压缩的空间。我们不仅要保证足够的成品率,还要保证加工效率,这对晶圆切割刀片和切割工艺是一个很大的挑战。从切割刀本身的制...