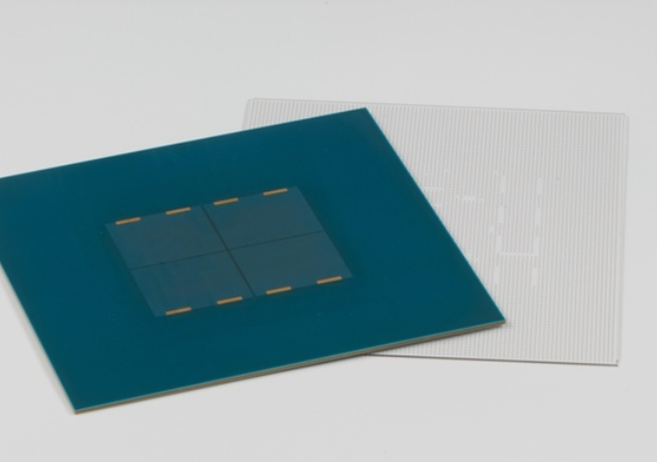 英特尔收缩玻璃基板自研业务在AI时代的推动下,玻璃基板技术的产业化步伐正在加速前进。
英特尔收缩玻璃基板自研业务在AI时代的推动下,玻璃基板技术的产业化步伐正在加速前进。
 2025年度人才招聘公告全国招聘,长期有效。
2025年度人才招聘公告全国招聘,长期有效。
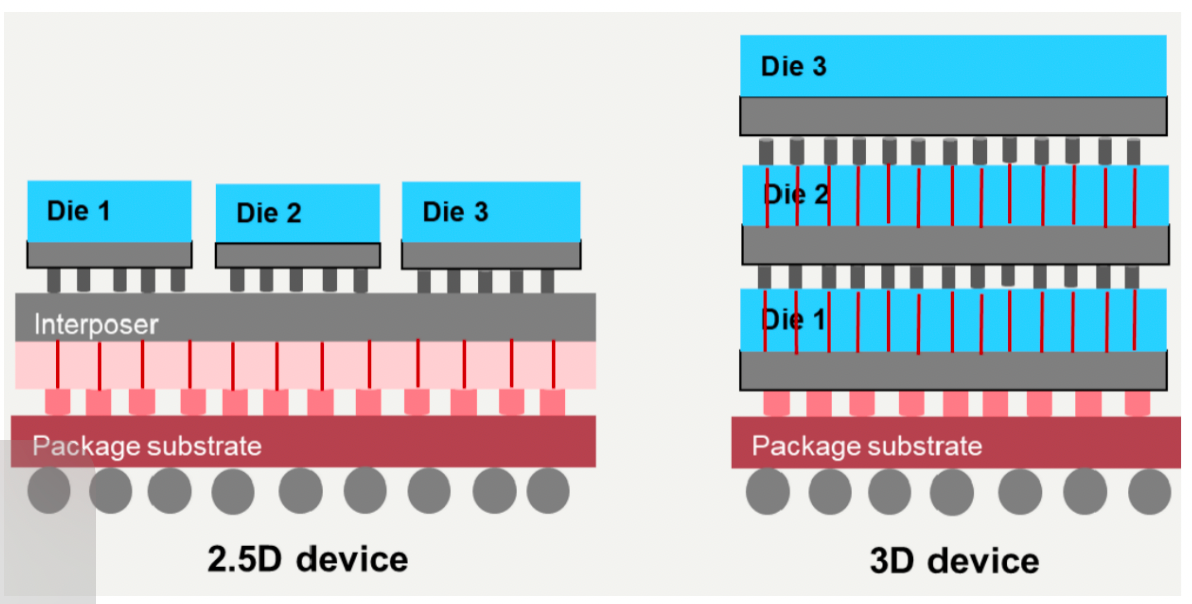 先进封装的几种形式一般来说,具备Bump、RDL、Wafer 和 TSV 四项基础要素中任意一种即可称为先进封装。
先进封装的几种形式一般来说,具备Bump、RDL、Wafer 和 TSV 四项基础要素中任意一种即可称为先进封装。
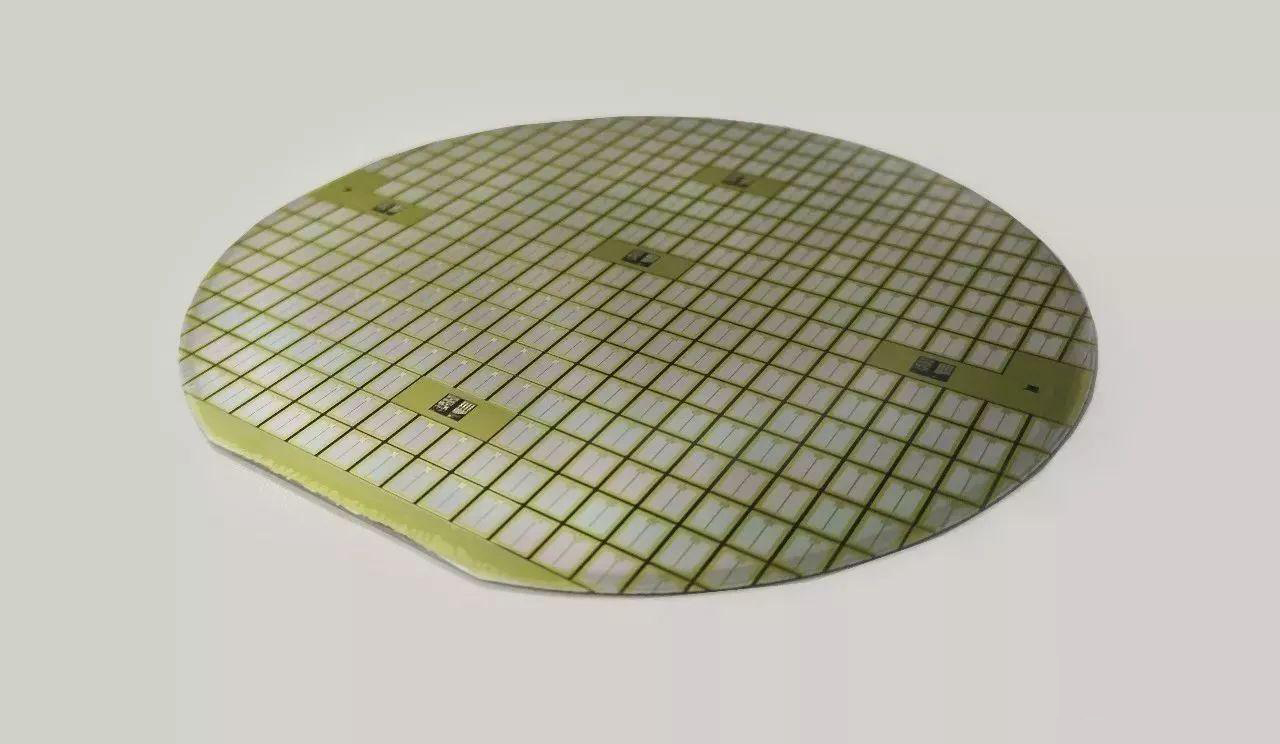 Macom专注提升GaN-on-SiC产能Macom通过收购Wolfspeed射频业务,拓展其在国防、航空航天等领域的应用场景。
Macom专注提升GaN-on-SiC产能Macom通过收购Wolfspeed射频业务,拓展其在国防、航空航天等领域的应用场景。
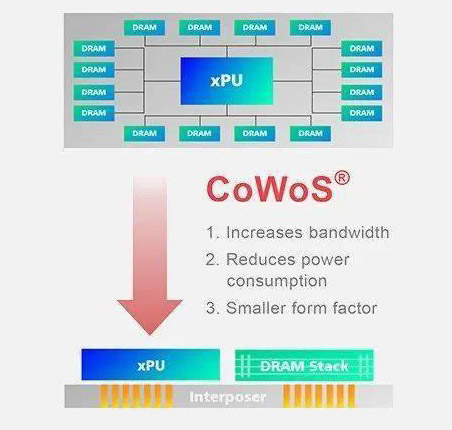 美国放开H20芯片出口中国限制CoWoS严格来说属于2.5D先进封装技术
美国放开H20芯片出口中国限制CoWoS严格来说属于2.5D先进封装技术
 碳化硅晶圆特性及切割要点导电型碳化硅,在切割时划片刀摩擦可能产生局部放电。
碳化硅晶圆特性及切割要点导电型碳化硅,在切割时划片刀摩擦可能产生局部放电。
 碳化硅衬底尺寸格局根据电学性能差异区分,碳化硅衬底分为导电型衬底和半绝缘型衬底。
碳化硅衬底尺寸格局根据电学性能差异区分,碳化硅衬底分为导电型衬底和半绝缘型衬底。
 小米YU7大卖,带动国产碳化硅供应链升级随着小米旗下车型的大批量交付,将助力国产碳化硅供应链进一步完善升级。
小米YU7大卖,带动国产碳化硅供应链升级随着小米旗下车型的大批量交付,将助力国产碳化硅供应链进一步完善升级。
 碳化硅将迎来快速增长SiC衬底是第三代半导体材料中氮化镓、SiC应用的基石。
碳化硅将迎来快速增长SiC衬底是第三代半导体材料中氮化镓、SiC应用的基石。
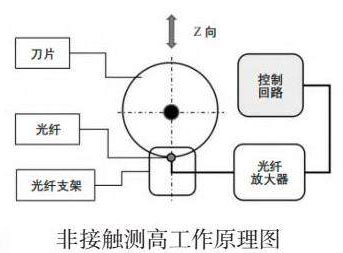 晶圆划切过程中怎么测高?目前测量刀片磨损有两种方式:接触测高和非接触测高。
晶圆划切过程中怎么测高?目前测量刀片磨损有两种方式:接触测高和非接触测高。